[고든 정의 TECH+] 인텔, 유기물 대신 유리 사용한 칩 공개, 게임 체인저 될까?
입력 2023 09 21 17:31
수정 2023 09 21 17:31
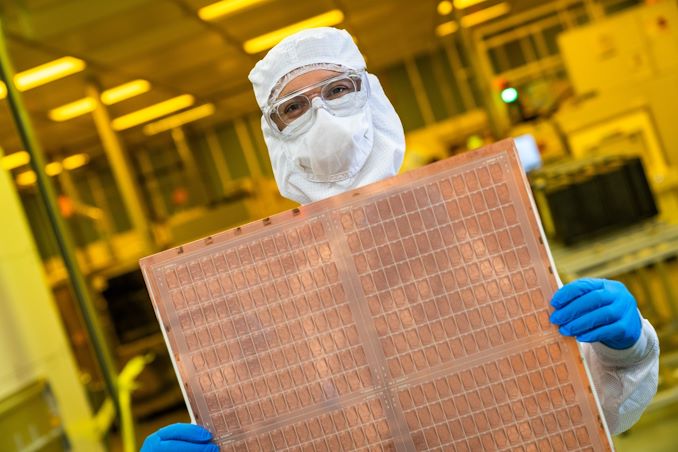
유리 기판 샘플. 출처: 인텔
하지만 반도체 제조사들이 미세 공정만 두고 경쟁을 벌이는 것은 아닙니다. 최근 들어 하나의 큰 칩을 생산하기 힘들어지면서 여러 개의 작은 칩 (칩렛 혹은 타일)을 연결해 하나의 큰 프로세서를 만드는 것이 새로운 추세로 자리 잡고 있습니다. 여러 개의 반도체 칩을 연결하고 제대로 작동하게 만드는 반도체 패키징 기술이 중요해진 것입니다.
현재 미세 공정에서 다른 경쟁자보다 뒤처진 상태인 인텔은 인텔4, 인텔 3, 20A, 18A 등 여러 개의 공정을 동시 개발하면서 경쟁자를 맹추격하고 있습니다. 여기에 더해 인텔은 반도체 실리콘 다이를 올려놓는 기반 (substrate)에서도 새로운 혁신을 예고했습니다.
현재 프로세서 패키징의 기반 물질은 유기물 (organic)입니다. 부서지기 쉬운 반도체 실리콘 다이는 1970년 대에는 금속 프레임 위에 올려 놨습니다. 1990년 대에는 세라믹이 사용됐고 200년 대 들어서는 유기물이 그 자리를 대신했습니다.

반도체 기판 소재 진화. 출처: 인텔
그러나 한때는 혁신이었던 유기물 기반 소재는 이제 시대의 요구를 충분히 만족시킬 수 없게 됐습니다. 여러 개의 칩을 고속으로 연결하기 위해서는 별도의 연결 통로나 아예 다른 반도체를 기반으로 올려 놓아야 하는 상황입니다. 칩의 크기가 점점 커지고 그에 따른 발열량이 증가하는 것도 문제점입니다.
업계에서 주목하는 차세대 기반 소재는 바로 유리입니다. 유리는 더 튼튼하고 열에 강할 뿐 아니라 데이터 전송 속도도 더 빠르게 만들 수 있습니다. 인텔은 10년 전부터 10억 달러 이상을 투입해 유리 코어 기반 (glass core substrate) 기술을 개발했습니다. 그리고 이제 실제로 작동하는 프로세서를 공개했습니다.
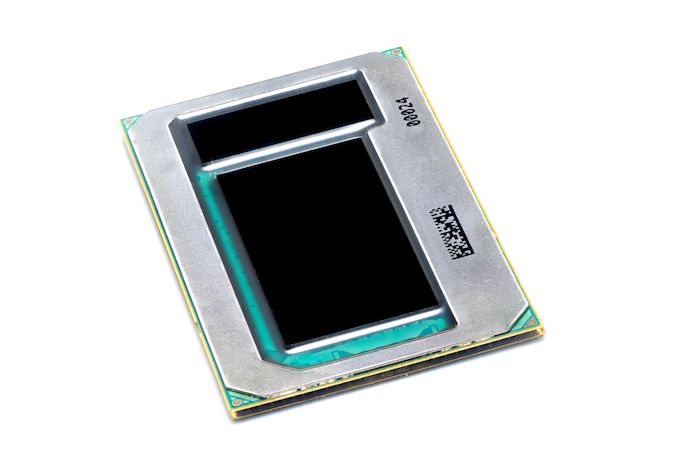
유리 코어 기반 프로세서 샘플. 출처: 인텔

유리 코어 기반 프로세서 샘플. 출처: 인텔
유리는 반도체 다이를 수직으로 연결하는 고속 연결 통로인 TSV와 유사한 TGV (Through Glass Via)를 만들 수 있습니다. 따라서 반도체의 TSV와 연결해 매우 빠른 입출력 속도를 확보하고 있습니다. 현재 프로세서의 성능이 높아지고 처리해야 하는 데이터 양이 많아진 점을 생각하면 중요한 특징입니다.
다만 기술적 혁신이 진짜 혁신이 되기 위해서는 합리적인 가격으로 시장에서 구매할 수 있어야 합니다. 샘플 칩을 내놓기는 했지만, 아직 유리 코어 기반 기술은 검증해야 하는 부분이 많기 때문에 시장에 진입하는 것은 가능하더라도 2030년대가 될 것으로 예상하고 있습니다.
인텔은 현재 개발 중인 최신 미세 공정과 유리 코어 기반 같은 다른 기술 혁신을 통해 2030년 대에는 지금의 10배인 1조 개의 트랜지스터를 집적한 프로세서가 나올 것으로 예측하고 있습니다. 과연 목표를 달성할 수 있을지 미래가 주목됩니다.
고든 정 과학 칼럼니스트 jjy0501@naver.com



























